 3D打印在芯片领域的一个经典应用是美国空军研究实验室(AFRL)和美国半导体通过3D打印制造的柔性硅芯片。新芯片的存储容量比任何同类产品大7,000倍,使其适合作为微控制器集成到其他物体中。
3D打印在芯片领域的一个经典应用是美国空军研究实验室(AFRL)和美国半导体通过3D打印制造的柔性硅芯片。新芯片的存储容量比任何同类产品大7,000倍,使其适合作为微控制器集成到其他物体中。
而国内武汉大学采用金属有机框架材料(Metal-organic Framework, MOF)作为原料,利用激光成功制备了颗粒大小均一的金属纳米晶粒。通过程序控制激光的开闭和光斑的移动实现了图案的制备,仅数十秒即可打印出由金属纳米晶粒构成的晶圆级别大小的芯片,整个过程完全在空气中进行,所需激光功率不到5瓦,适合规模化生产。
 3D打印在电子领域的应用。来源:3D科学谷《3D打印与电子产品白皮书 1.0》
3D打印在电子领域的应用。来源:3D科学谷《3D打印与电子产品白皮书 1.0》
而对于芯片的开发来说,除了具备材料技术以及3D打印的经验,热仿真是关键的一环。本期,谷.专栏通过安世亚太的仿真专家分享《热仿真在芯片研发中的作用》以呈现芯片开发的别有洞天。
随着现代社会的智能化发展,在人类生活的各个角落,无论是汽车电子还是人工智能,再或是AR、VR,以及其他新科技应用领域,半导体芯片都是智能化控制的最基础、最核心的部分。高度集成的封装及电路控制可以帮助人类完成各种各样的工作。
使用ANSYS Icepak可以精确地计算芯片封装内部的热流分布,计算不同工况下的热阻数值,方便工程师洞悉芯片内部的热流路径,以进一步改善芯片的热流环境,提高其热可靠性。
为满足智能化、微型化的需求,芯片被最大程度地封装集成,多个芯片(chip)或并列封装于一个Package中,形成SIP(System In a Package)系统级封装,或进行Stacked堆叠封装,形成堆栈裸片封装。
众所周知,当电流流经导体时,必然会生成焦耳热,热量的不平均势必引起导体的热变形等不良现象,那么对于高度集成的芯片封装,在其工作时,芯片内部的热耗势必急剧增大,进而导致芯片内部温度升高,因此在芯片封装的研发过程中,芯片封装的过热问题必须得到良好的控制。
正如华为总裁任正非2018年接受记者采访时讲到“我们把芯片叠起来,但最大的问题是要把两个芯片中间的热量散出来,这也是尖端技术,所以说,热学将是电子工业中最尖端的科学,这方面我们的研究也是领先的,就是太抽象了”,那么在芯片封装的研发过程中,工程师可以使用ANSYS Icepak对芯片封装内部的热流场进行CAE仿真计算,也可以和ANSYS其他模块一起,进行芯片封装的多物理场耦合模拟计算,以便调控热流传递路径,更好地降低芯片Die的温度,提高其热可靠性。下图为某芯片内部的热流密度及温度云图,可以看出,芯片内部的温度极其不均匀。
ANSYS Icepak作为一款优异的电子热仿真软件,可以对芯片封装的各个尺度进行热流仿真计算,小到芯片内部0.25μm的沟道,大到cm厘米级别的封装、芯片,都可以对其进行有效精确的热流仿真计算。当前,在芯片封装的CAE热流计算中,主要是计算了芯片封装放置于JEDEC(美国联合电子设备工程协会)标准机箱内自然冷却、强迫对流情况下的热阻数值。芯片封装内的铜箔布线和过孔,是芯片热流最重要的传热路径,因此在对芯片进行详细的热流计算时,务必导入其布线过孔信息,以提高热仿真计算的精度。
芯片封装热流计算常见的几种热阻分类如下:
- 芯片封装的Rja热阻,表示芯片的结点Junction与外界空气的热阻,单位为℃/W,一般由芯片制造商提供。Rja热阻数值的大小,通常被用来判断芯片散热性能的好坏。下图表示某个芯片的Rja热阻数值(包括自然冷却和强迫风冷)。
Rja热阻通常包括两种,一种为将芯片放置于JEDEC标准的密闭测试机箱中,芯片通过自然冷却进行散热,即外侧风速为0,计算芯片封装的Rja;另一种为将芯片放置于JEDEC标准的风洞中,通过外界的强迫风冷对芯片进行散热,需要计算不同风速下的芯片Rja热阻,其中风洞垂直距离h应该大于测试电路板流向长度L的2倍,即h>2L。
芯片Rja热阻的计算公式如下所示:
Rja=(Tj-Ta)/P
Rja表示芯片结点Junction至环境空气的热阻,℃/W;
Tj表示芯片Die的最高温度,℃;
Ta表示环境的空气温度,℃;
P表示芯片Die的热耗,W;Tj、Ta测量点示意图如下图所示。
进行Rja计算时,芯片务必放置于电路板上,当芯片封装的尺寸小于27mm时,测试电路板的尺寸如下左图所示;当芯片封装尺寸大于等于27mm时,测试电路板的尺寸如下右图所示。
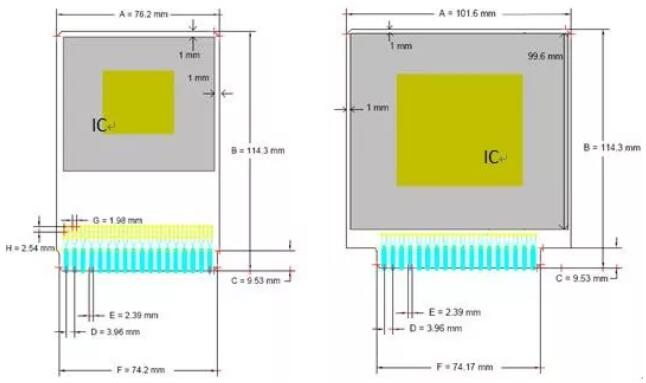 芯片尺寸小于27mm(左),芯片尺寸大于等于27mm(右)。来源:安世亚太
芯片尺寸小于27mm(左),芯片尺寸大于等于27mm(右)。来源:安世亚太
- 芯片封装的Rjc热阻,表示芯片封装的结点Die至芯片管壳Case顶部的热阻。将芯片封装放置于四周绝热的环境中,芯片封装仅仅通过管壳的顶部与外接环境进行换热,恒定的换热系数为25w/k.m2。Rjc测试的示意图如下图所示。
Rjc的计算公式为:
Rjc=(Tj-T_c)/P
Tj表示芯片Die的最高温度,℃;
Tc表示芯片管壳Case的最高温度,℃;
P表示芯片Die的热耗,W。
- 芯片封装的Rjb热阻,表示芯片封装的结点Die至电路板Board的热阻,其真实的测试示意图下图所示。芯片封装放置于Pcb电路板上,电路板长、宽方向的尺寸均大于芯片封装5mm,将芯片和电路板放置于密闭的空间内,电路板四周的面处于恒定的温度,芯片封装的热量只能通过电路板传导至电路板四周恒温的壁面。
芯片封装Rjb的计算公式为:
Rjb=(Tj-T_b)/P
Tj表示芯片Die的最高温度,℃;
Tb表示电路板board的温度,℃;
P表示芯片Die的热耗,W。
因此,使用ANSYS Icepak可以精确地计算芯片封装内部的热流分布,计算不同工况下的热阻数值,方便工程师洞悉芯片内部的热流路径,以进一步改善芯片的热流环境,提高其热可靠性。
关于3D打印在电子结构件领域的应用,请参考《3D打印与电子产品白皮书》。
王永康
北京科技大学工程热物理专业硕士,现任安世亚太科技股份有限公司ANSYS Icepak产品经理;工作至今,做过数十个电子产品热设计优化的咨询项目;擅长电子产品热设计基础理论培训、ANSYS Icepak软件基础培训、ANSYS Icepak软件高级培训、电子产品热设计导航培训、电子产品热设计优化咨询等领域。
《3D打印与工业制造》登陆京东网上书店,点击微课视频收看超过9万人观看的3D科学谷创始人微课。
资料下载,请加入3D科学谷3D产业链QQ群:529965687
更多信息或查找往期文章,请登陆www.3dsciencevalley.com,
在首页搜索关键词 网站投稿请发送至2509957133@qq.com